晶圆级封装技术有什么特点和应用
引言
晶圆级封装技术是什么?晶圆级封装是指在将要制造集成电路的晶圆分离成单独的电路之前,通过在每个电路周围施加封装来制造集成电路。由于在部件尺寸以及生产时间和成本方面的优势,该技术在集成电路行业中迅速流行起来。以此方式制造的组件被认为是芯片级封装的一种。这意味着其尺寸几乎与内部电子电路所位于的裸片的尺寸相同。

特点
集成电路的常规制造通常开始于将在其上制造电路的硅晶片的生产。通常将纯硅锭切成薄片,称为晶圆,这是建立微电子电路的基础。这些电路通过称为晶圆切割的工艺来分离。分离后,将它们封装成单独的组件,然后将焊料引线施加到封装上。
晶圆级封装在封装方式上与传统制造不同。该技术不是将电路分开然后在继续进行测试之前应用封装和引线,而是用于集成多个步骤。在晶片切割之前,将封装的顶部和底部以及焊锡引线应用于每个集成电路。测试通常也发生在晶片切割之前。更高级的应用是利用硅穿孔TSV技术进行堆叠,铜柱连接键合等晶圆键合技术。
像许多其他常见的组件封装类型一样,用晶圆级封装制造的集成电路是一种表面安装技术。通过熔化附着在元件上的焊球,将表面安装器件直接应用于电路板的表面。晶圆级组件通常可以与其他表面贴装设备类似地使用。例如,它们通常可以在卷带机上,以用于称为拾取和放置机器的自动化组件放置系统。
技术优点
晶圆级封装的实现可以带来许多经济利益。它允许晶圆制造,封装和测试的集成,从而简化制造过程。缩短的制造周期时间可提高生产量并降低每单位制造成本。
晶圆级封装还可以减小封装尺寸,从而节省材料并进一步降低生产成本。然而,更重要的是,减小的封装尺寸允许组件用于更广范的高级产品中。晶圆级封装的主要市场驱动因素之一是需要更小的组件尺寸,尤其是减小封装高度。
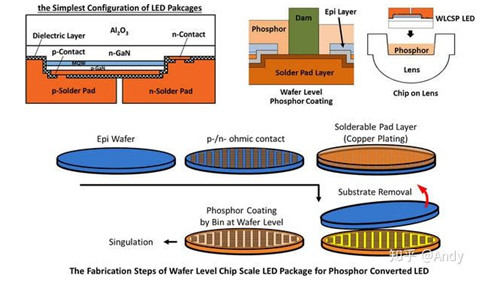
用晶圆级封装制造的组件被广范用于手机等消费电子产品中。这主要是由于市场对更小,更轻的电子设备的需求,这些电子设备可以以越来越复杂的方式使用。例如,除了简单的通话外,许多手机还具有多种功能,例如拍照或录制视频。晶圆级封装也已用于多种其他应用中。例如,它们用于汽车轮胎压力监测系统,可植入医疗设备,军事数据传输系统等。
可用设备
晶圆级封装能用的设备包括EVG晶圆键合机,掩模对准光刻机,纳米压印设备,另外可能还需要膜厚测量仪,轮廓仪,晶圆清洗机等用于晶圆形貌测量和晶圆表面清洗去污等工艺过程。
关于驰飞
驰飞的解决方案是环保、高效和高度可靠的,可大幅减少过量喷涂,节省原材料,并提高均一性、转移效率、均匀性和减少排放。为企业提供围绕功能涂层的全套解决方案及长期技术支持,保证客户涂层稳定量产;针对特殊器械涂层需求,提供涂层定制研发服务;提供各类涂层代工服务。
杭州驰飞是超声镀膜系统开发商和制造商,产品主要应用于燃料电池质子交换膜喷涂、薄膜太阳能电池、钙钛矿、微电子、半导体、 纳米新材料、玻璃镀膜、 生物医疗、纺织品等领域。


